01
Indledning
Wafer-terninger er en vigtig del af fremstilling af halvlederenheder. Skæringsmetoden og kvaliteten påvirker direkte waferens tykkelse, ruhed, dimensioner og produktionsomkostninger og har en betydelig indvirkning på apparatets fremstilling. Siliciumcarbid er som tredje-generations halvledermateriale et vigtigt materiale, der driver den elektriske revolution. Produktionsomkostningerne for krystallinsk siliciumcarbid af høj-kvalitet er ekstremt høj, og folk håber generelt på at skære en stor siliciumcarbidbarre i så mange tynde siliciumcarbidwafersubstrater som muligt. Samtidig har industriens vækst ført til gradvist større waferstørrelser, hvilket har øget kravene til terningsprocesser. Siliciumcarbid er dog ekstremt hårdt, med en Mohs hårdhed på 9,5, kun næst efter diamant (10), og det er også skørt, hvilket gør det svært at skære. I øjeblikket bruger industrielle metoder generelt savning af gylletråd eller diamanttrådssavning. Under skæring placeres faste trådsave med lige store afstande rundt om siliciumcarbidbarren, og barren skæres ved hjælp af strakte trådsave. Ved at bruge trådsavsmetoden tager det cirka 100 timer at adskille wafers fra en 6-tommers diameter barre. De resulterende wafers har relativt brede snit, ru overflader og materialetab så højt som 46%. Dette øger omkostningerne ved at bruge siliciumcarbidmaterialer og begrænser deres udvikling i halvlederindustrien, hvilket understreger det presserende behov for forskning i nye siliciumcarbidwafer-skæreteknologier.
I de senere år er brugen af laserskæringsteknologi blevet mere og mere populær inden for fremstilling af halvledermaterialer. Denne metode fungerer ved at bruge en fokuseret laserstråle til at modificere materialets overflade eller indre og derved adskille den. Som en ikke-kontaktproces undgår den værktøjsslid og mekanisk belastning. Derfor forbedrer det i høj grad waferoverfladeruheden og præcisionen, eliminerer behovet for efterfølgende poleringsprocesser, reducerer materialetab, sænker omkostningerne og minimerer miljøforurening forårsaget af traditionel slibning og polering. Laserskæringsteknologi har længe været anvendt til skæring af siliciumbarre, men dens anvendelse i siliciumcarbidområdet er stadig umoden. I øjeblikket er der flere hovedteknikker.
02
Vand-Vejledt laserskæring
Vand-styret laserteknologi (Laser MicroJet, LMJ), også kendt som lasermikro-jetteknologi, fungerer efter princippet om at fokusere en laserstråle på en dyse, når den passerer gennem et tryk-moduleret vandkammer. En lav-vandstråle udstødes fra dysen, og på grund af forskellen i brydningsindeks ved vand-luftgrænsefladen dannes en lysbølgeleder, som tillader laseren at udbrede sig langs vandstrømmens retning. Dette guider en-højtryksvandstråle til at behandle og skære materialets overflade. Den største fordel ved vand-styret laserskæring ligger i dens skærekvalitet. Vandstrømmen afkøler ikke kun skæreområdet, hvilket reducerer termisk deformation og termisk skade på materialet, men fjerner også forarbejdningsaffald. Sammenlignet med wiresavskæring er det væsentligt hurtigere. Men fordi vand absorberer forskellige laserbølgelængder i varierende grad, er laserbølgelængden begrænset, primært til 1064 nm, 532 nm og 355 nm.
I 1993 foreslog den schweiziske videnskabsmand Beruold Richerzhagen først denne teknologi. Han grundlagde Synova, en virksomhed dedikeret til forskning, udvikling og kommercialisering af vand-styret laserteknologi, som er internationalt i front. Indenlandsk teknologi er relativt bagud, men virksomheder som Innolight og Shengguang Silicon Research udvikler det aktivt.

03
Stealth terninger
Stealth Dicing (SD) er en teknik, hvor en laser fokuseres inde i en siliciumcarbidwafer gennem dens overflade for at danne et modificeret lag i den ønskede dybde, hvilket muliggør waferseparation. Da der ikke er nogen snit på waferoverfladen, kan der opnås højere behandlingspræcision. SD-processen med nanosekund-pulslasere er allerede blevet brugt industrielt til at adskille siliciumwafers. Under SD-behandlingen af siliciumcarbid induceret af nanosekundpulslasere er pulsvarigheden dog meget længere end koblingstiden mellem elektroner og fononer i siliciumcarbid (på picosekundskalaen), hvilket resulterer i termiske effekter. Det høje termiske input på waferen gør ikke kun adskillelsen tilbøjelig til at afvige fra den ønskede retning, men genererer også betydelig restspænding, hvilket fører til brud og dårlig spaltning. Ved behandling af siliciumcarbid bruger SD-processen derfor typisk ultrakorte pulslasere, hvilket i høj grad reducerer termiske effekter.
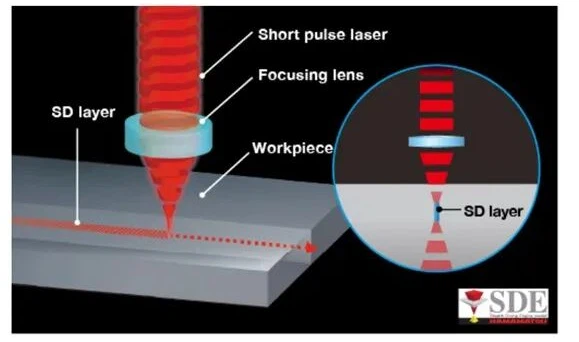
Det japanske firma DISCO har udviklet en laserskæringsteknologi kaldet Key Amorphous-Black Repetitive Absorption (KABRA). For eksempel ved at behandle 20 mm tykke siliciumcarbid barrer med en diameter på 6-tommer, øgede det produktiviteten af siliciumcarbid wafers firedobbelt. KABRA-processen fokuserer i det væsentlige laseren inde i siliciumcarbidmaterialet. Gennem 'amorf-sort gentagne absorption' nedbrydes siliciumcarbidet til amorft silicium og amorft kulstof, der danner et lag, der tjener som et wafer-adskillelsespunkt, kendt som det sorte amorfe lag, som absorberer mere lys, hvilket gør det meget lettere at adskille waferne.

Cold Split wafer-teknologien udviklet af Siltectra, som blev erhvervet af Infineon, kan ikke kun opdele forskellige typer barrer i wafers, men reducerer også materialetab med op til 90%, hvor hver wafer taber så lidt som 80µm, hvilket i sidste ende sænker de samlede produktionsomkostninger for enheden med op til 30%. Cold Split-teknologien involverer to trin: For det første bestråler en laser barren for at skabe et delamineringslag, hvilket forårsager intern volumenudvidelse i siliciumcarbidmaterialet, som genererer trækspænding og danner en meget smal mikro-revne; derefter forvandler et polymerafkølingstrin mikro-revnen til en hovedrevne, der til sidst adskiller waferen fra den resterende ingot. I 2019 evaluerede en tredjepart denne teknologi og målte overfladeruheden Ra af de delte wafere til at være mindre end 3µm, med de bedste resultater på mindre end 2µm.

Den modificerede laserskæring udviklet af det kinesiske firma Han's Laser er en laserteknologi, der bruges til at adskille halvlederskiver i individuelle chips eller matricer. Denne proces bruger også en præcis laserstråle til at scanne og danne et modificeret lag inde i waferen, hvilket tillader waferen at revne langs laserscanningsvejen under påført stress, hvilket opnår præcis adskillelse.
Figur 5. Modificeret laserskæringsprocesflow
I øjeblikket har indenlandske producenter mestret gylle-baseret siliciumcarbidskæreteknologi. Imidlertid har gylleskæring stort materialetab, lav effektivitet og alvorlig forurening og erstattes gradvist af diamanttrådsteknologi. Samtidig skiller laserskæring sig ud på grund af dens ydeevne og effektivitetsfordele. Sammenlignet med traditionelle mekaniske kontaktbehandlingsteknologier tilbyder den mange fordele, herunder høj forarbejdningseffektivitet, smalle rillelinjer og høj skæretæthed, hvilket gør den til en stærk konkurrent til at erstatte diamanttrådsskæring. Det åbner en ny vej for anvendelsen af næste-generations halvledermaterialer såsom siliciumcarbid. Med fremskridt inden for industriel teknologi og den kontinuerlige stigning i størrelser på siliciumcarbidsubstrater, vil siliciumcarbidskæreteknologi udvikle sig hurtigt, og effektiv laserskæring af høj-kvalitet vil være en vigtig trend for fremtidig siliciumcarbidskæring.









